- BUEHLER TECHNotes -
电子元器件焊点
切片分析及目的


随着电子产品微型化与高密度集成化的发展趋势,焊点质量直接影响电子设备可靠性。
从智能手机到航空航天系统,这些电子元件与印刷电路板(PCB)之间的连接虽小,但却至关重要,是保持电气功能和机械完整性的关键。

端子焊接点和 BGA焊接示意图

然而焊点也是电子设备中常见的故障点,因此其可靠性至关重要。
本文主要解析电子样品焊点常见缺陷类型。
焊点切片分析核心目的

IMC(金属间化合物)的形成
在焊接过程中,Sn(锡)、Cu(铜)、Ni(镍)等金属原子在高温下相互扩散、迁移和结合,通过复杂的物理化学作用,最终形成金属间化合物(IMC)。
这些IMC在焊接中起着关键的连接作用。例如,铜-锡界面在半导体封装工艺中常常会形成具有特定形貌的锯齿状IMC 。


IMC厚度示意图
在典型的BGA(球栅阵列)焊点中,需要保持3-5μm的连续IMC层,以确保良好的电气连接和机械强度。
然而,如果IMC层过厚或形成时间过长,可能会导致应力集中,进而引发微裂纹和Kirkendall孔等缺陷。
这些缺陷会显著降低焊点的机械强度和疲劳性能,从而影响整个焊接接头的可靠性和使用寿命。

焊点空洞
焊点中的空洞是焊接过程中因气体残留或金属间化学反应而形成的内部缺陷。
这些气体可能来源于助焊剂的挥发、金属中的夹杂物或焊接环境中的水分等,同时体积收缩也是一个重要因素。
这些空洞通常是由助焊剂在高温下裂解产生的气体无法及时逸出,或是焊接材料在冷却过程中体积收缩而形成。
它们会导致有效焊接面积显著减少,并在焊点内部造成应力集中,从而影响焊点的机械强度和可靠性。

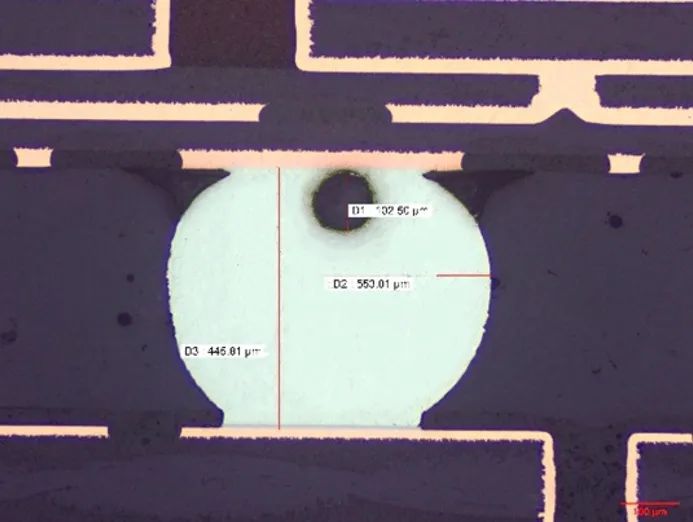
焊点中的空洞
IPC-A-610标准明确规定,BGA(球栅阵列)焊点的空洞面积占比需控制在25%以下,以确保焊点的质量和性能。
这一标准是通过切片检测等检测技术来判定焊点空洞面积占比的,从而确保焊点的可靠性和稳定性。

裂缝和疲劳故障
焊点裂纹与疲劳故障主要由热循环、机械应力引起,如:
汽车电子发动机舱或电池管理系统中的电子样品需承受-40°C至150°C的剧烈温度波动,焊点易因热循环疲劳失效;
航空航天设备在高海拔或温差环境下,焊点界面应力集中问题突出,且振动载荷进一步加剧裂纹扩展风险。
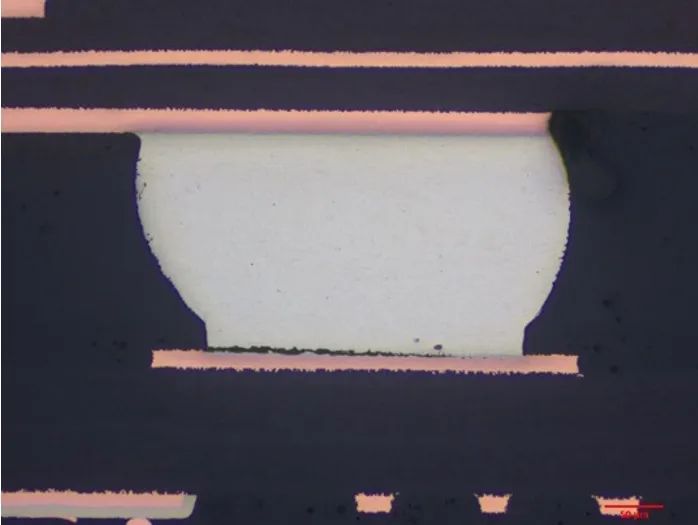

焊点周围的裂纹

结论
金相分析通过精准确定失效机制、优化IMC生成及验证材料适配性,成为提升焊点可靠性的核心手段。
结合自动化制备与显微检测技术,可显著提升焊接质量,满足汽车、航空航天等领域对高密度电子器件的严苛可靠性需求。
相关产品
免责声明
- 凡本网注明“来源:化工仪器网”的所有作品,均为浙江兴旺宝明通网络有限公司-化工仪器网合法拥有版权或有权使用的作品,未经本网授权不得转载、摘编或利用其它方式使用上述作品。已经本网授权使用作品的,应在授权范围内使用,并注明“来源:化工仪器网”。违反上述声明者,本网将追究其相关法律责任。
- 本网转载并注明自其他来源(非化工仪器网)的作品,目的在于传递更多信息,并不代表本网赞同其观点和对其真实性负责,不承担此类作品侵权行为的直接责任及连带责任。其他媒体、网站或个人从本网转载时,必须保留本网注明的作品第一来源,并自负版权等法律责任。
- 如涉及作品内容、版权等问题,请在作品发表之日起一周内与本网联系,否则视为放弃相关权利。
 手机版
手机版 化工仪器网手机版
化工仪器网手机版
 化工仪器网小程序
化工仪器网小程序
 官方微信
官方微信 公众号:chem17
公众号:chem17
 扫码关注视频号
扫码关注视频号




















 采购中心
采购中心